|

Промышленные источники широких ионных пучков
Сотрудники компании Kaufman & Robinson, Inc.
ВВЕДЕНИЕ 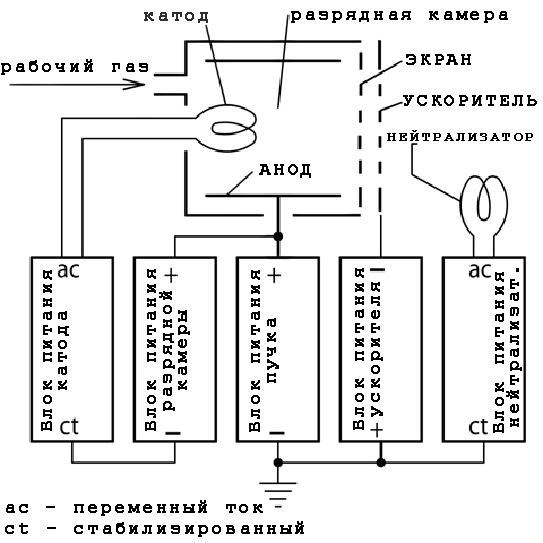
Обычно, широкие ионные пучки бывают несколько или более сантиметров в диаметре. Кроме того, диаметр такого пучка намного больше дебаевской длины, которая является типовым расстоянием, на которое электрическое поле может проникнуть в плазму. Если в широком пучке надо поддерживать околонулевой потенциал, он может быть нейтрализован (см. Tech. Note KRI-02). Для нейтрализации необходимо, чтобы в любом объеме ионного пучка было примерно равное количество электронов и положительно заряженных ионов. На диэлектрические мишени электроны и ионы должны приходить в равном количестве. Мишенью может служить либо распыляемая мишень, либо подложка. Энергия ионов в широком пучке равна 2000 эВ или менее. (Одиночный заряженный ион, проходя через разницу потенциалов в 2000 В, получает энергию в 2000 эВ). Обычно, для минимизации повреждений, энергия составляет 1000 эВ или менее. Здесь не рассматриваются высокоэнергетические приложения внедрения. Проблема повреждений обрабатываемой поверхности вынуждает понижать энергию ионов. Существуют два общих вида источников широких ионных пучков: сеточные и бессеточные.
СЕТОЧНЫЕ ИОННЫЕ ИСТОЧНИКИ
Схема сеточного ионного источника показана на рис. 1, на котором изображена разрядная камера с постоянным магнитным полем. Ионы генерируются разрядом либо в круглой, либо в продолговатой разрядной камере. Могут использоваться несколько типов испускающих электроны катодов. На рис. 1 показан тип разогретой нити. Также ионы могут генерироваться ВЧ-индукцией, для которой не требуется эмиссирующего катода. При генерации пучка в разрядной камере поддерживается положительный потенциал. Ионы разгоняются через отверстия в экране и ускоряющей сетке, которые вместе называются ионной оптикой.
Сетки могут быть разных конструкций. Наиболее часто используется показанная на рис. двух сеточная оптика. В разрядной камере с постоянным полем экранирующая сетка запирается потенциалом катода. В камерах с ВЧ-индукцией экран подключается к положительному контакту источника пучка. Положительно-заряженные ионы ускоряются в разрядной камере с положительным потенциалом, проходят через ионную оптику и достигают мишени с близким к нулю потенциалом. Ускоряющая сетка по отношению к окружающей вакуумной камере (с нулевым потенциалом) имеет отрицательный потенциал, который удерживает электроны из нейтрализатора от движения в обратном направлении через ионную оптику. Если рассматривать однозарядные ионы, свойственные этому типу ионных источников при их нормальной работе, то ионы получает энергию в эВ (электрон-вольтах), равную напряжению в вольтах, приложенному к источнику.Сеточные ионные источники работают при окружающем давлении около 0,5 миллиторра или меньше. Их производительность зависит от конструкции ионной оптики. Ток пучка увеличивается если расстояние между сетками уменьшается, а число отверстий увеличивается. Ионный пучок может быть сфокусирован для покрытия малых площадей, коллимирован или дефокусирован для охвата больших площадей. Это зависит от формы сеток и относительного расположения отверстий в них. Для конкретной оптики ток ионного пучка Ib зависит от общей разницы потенциалов между сетками, ΔVt
Ib∞ ΔVt3/2(1)
Соотношение (1) показывает, что при низких напряжениях ток пучка ионов резко уменьшается. Может показаться, что большие токи ионного пучка могут быть получены при низком напряжении путем увеличения отрицательного ускоряющего напряжения. Но большое отрицательное напряжение может привести к расхождению ионного пучка до такой степени, что ионный ток, попадающий на мишень, реально уменьшится. При большом отрицательном напряжении расхождение пучка может уменьшить трехсеточная ионная оптика, но при ограниченной эффективности и других компромиссах.
Независимо от того, какая используется ионная оптика, сеточные источники при низких энергиях ионов не могут приблизиться к возможностям по ионному току бессеточных ионных источников Энд-Холл. Кроме того, ионная оптика, которая обеспечит наилучший контроль траекторий ионов, будет наиболее дорогой частью сеточного ионного источника и потребует более дорогого обслуживания.
БЕССЕТОЧНЫЕ ИОННЫЕ ИСТОЧНИКИ
Существует много типов бессеточных ионных источников [2,3], но в промышленности широко используются только источники Энд-Холл и источники прианодного слоя. Ионы в бессеточном источнике генерируются приложенным к разрядной камере напряжением и разгоняются разницей потенциалов, образуемой электронами из катода-нейтрализатора, пересекающими линии магнитного поля по пути к аноду (на рис. не показано).
Ионные источники Энд-Холл
 Ионный источник Энд-Холл [2,4] показан на рис. 2. Он имеет разрядную камеру круглой или продолговатой формы. Разгон ионов происходит в квазинейтральной плазме с приблизительно равными плотностями электронов и ионов. Следовательно, нет ограничений на величину тока ионного пучка Ib, как это показывает соотношение (1). Ток ионного пучка равен примерно 20-30% тока разряда, а средняя энергия ионов соответствует примерно 60-70% напряжения разряда. Ионный источник Энд-Холл работает при окружающем давлении около одного миллиторра или меньше. По сравнению с сеточными ионными источниками, он надежнее и прочнее и способен генерировать большие ионные токи при энергии ионов 200 эВ или менее. Но он не способен без лишних усилий генерировать ионы более высоких энергий, а форма ионного пучка может быть только расходящейся. Ионный источник Энд-Холл [2,4] показан на рис. 2. Он имеет разрядную камеру круглой или продолговатой формы. Разгон ионов происходит в квазинейтральной плазме с приблизительно равными плотностями электронов и ионов. Следовательно, нет ограничений на величину тока ионного пучка Ib, как это показывает соотношение (1). Ток ионного пучка равен примерно 20-30% тока разряда, а средняя энергия ионов соответствует примерно 60-70% напряжения разряда. Ионный источник Энд-Холл работает при окружающем давлении около одного миллиторра или меньше. По сравнению с сеточными ионными источниками, он надежнее и прочнее и способен генерировать большие ионные токи при энергии ионов 200 эВ или менее. Но он не способен без лишних усилий генерировать ионы более высоких энергий, а форма ионного пучка может быть только расходящейся.
Ионный источник прианодного слоя
 Ионный источник прианодного слоя показан на рис. 3. Он также известен как ионный источник с замкнутым дрейфом, который основан на прецессировании электронов по замкнутому пути внутри кольцевой или продолговатой разрядной камеры. Источник прианодного слоя – тип источника с замкнутым дрейфом, в котором наибольший разгон происходит в тонком слое около анода [3]. Кроме того, существуют различные режимы работы таких источников. Используемые в промышленности источники этого типа работают в режиме вакуума без катода-нейтрализатора, как это показано на рис. 3 [3]. Напряжение разряда составляет примерно 800 - 2000 В, а энергия ионов больше, чем у ионного источника Энд-Холл. Эти источники работают при давлении в камере в несколько миллиторр или меньше [5]. Для привлечения нейтрализующих электронов из окружающие среды потенциал ионного пучка должен быть увеличен, вследствие чего мишень подвергается воздействию более сильных электрических полей, а диэлектрические мишени – более высоким потенциалам. По этой причине может произойти повреждение мишени. Характеристики источника могут ухудшиться из-за напыления или деформирования полюсных электродов или анода. Однако, если этот источник может решить поставленную задачу с удовлетворительным качеством, то это – очень простой тип ионного источника.
ЛИТЕРАТУРА
1 . H.R. Kaufman, “Technology of Ion Beam Sources Used in Sputtering,” J. of Vacuum Science and Technology, Vol. 15, pp. 272-276, Mar./Apr. 1978.
2. H.R. Kaufman, R. S. Robinson, and R. I. Seddon, “End- Hall Ion Source,” J. of Vacuum Science and Technology A, Vol. A5, pp. 2081-2084, July/Aug. 1987.
3. V.V. Zhurin, H.R. Kaufman, and R.S. Robinson, “Physics of Closed Drift Thrusters,” (Review article) Plasma Sources Sci. Technol., Vol. 8, pp. R1-R20, 1999.
4. H.R. Kaufman and R. S. Robinson, “End-Hall Ion Source,”
U.S. Patent 4,862,032, Aug. 29, 1989.
5. J.E. Keem, “High Current Density Anode Layer Ion Sources,” pp. 388-393, Proceedings SVC 44th Annual Technical Conference (2001).
|
|




